Diffusion Furnaces



Athmospheric Process
• Wet or dry oxidation
• Thick oxide (15um)
• Well drive in
• H2, N2 annealing
• POCL3 doping
• BBr3, B2H6 doping
LP-CVD Process
• Poly Si
• D-Poly Si
• Nitride: Si3N4
• Low stress Nitride (250MPa)
• Super Low stress Nitride (250MPa)
• Oxide – LTO, MTO, HTO, TEOS
• Thick oxide: TEOD (2um up)
• Sic
WMVF-4 Series
Features
• Compact design, very small footprint
• Automatic boat elevator
• Supported small size sample wafers
• R&D type
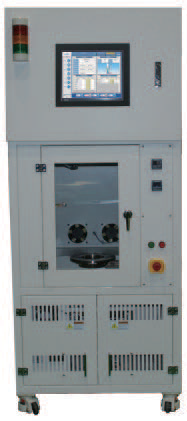
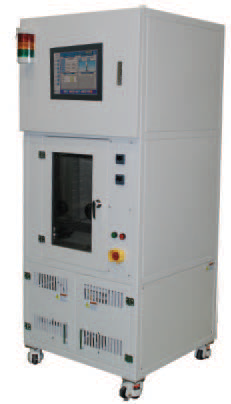
| MODEL | WMVF-4 Series | |
|---|---|---|
| Application processes | Atmospheric Processes
| LP-CVD Processes
|
| Temperature Control Range | 200°C to 1150°C | |
| Temperature Control Zone | 3 Zone | |
| Temperature Accuracy | ±1 at 200°C to 500°C , ±0.5 at 600°C to 1150°C | |
| Uniformity of Film Thickness | N2, O2, Ar, H2, N2O, SiH4, NH3, B2H6, PH3, SiH2Cl2 | |
| Possible Process Gases | PC-Base (Windows XP) PLC Control | |
| Controller Type | PC-Base (Windows XP) PLC Control | |
| Display | 15” TFT Touch LCD Monitor | |
| Wafer Size | 150mm or less | |
| Batch Size | 25 Wafers | |
| Auto Loader | 1 Axis Loader (Z Axis) | |
| Dimension(W*D*H) | 850 * 800 * 2000 (unit : mm) | |
| Power Supply | 3 Phase 380V, 60A (system will be modified to country-specific power supply) | |
| Cooling Water | Max. 10 LPM / Tube | |
| Compressed Dry Air | 500 ~ 600 KPa | |
| Heat Exhaust | 150 m3/h |
Diffusion Furnace Parts Available!
Click the button below to view the current Diffusion Furnace Parts list
View Available Parts